製品・技術 2025.05.30
最先端ICパッケージ基板の微細パッドを4端子で確実に検査 フライングプローブテスタ FA1823 受注開始
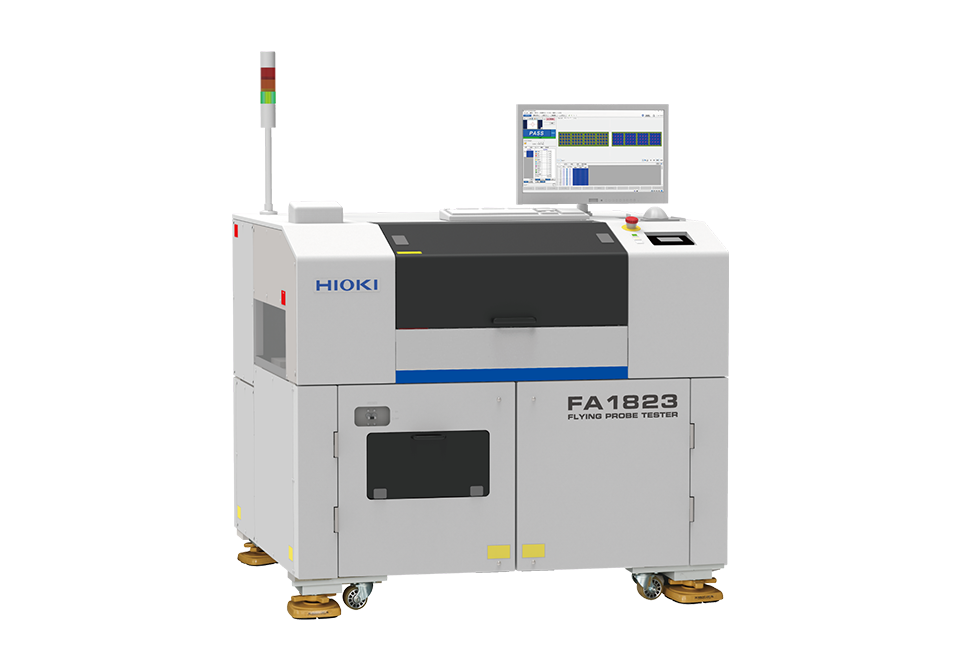 フライングプローブテスタFA1823
フライングプローブテスタFA1823
HIOKI(日置電機株式会社:長野県上田市、代表取締役社長:岡澤尊宏)は、2025年5月1日、ICパッケージ基板※1のさらなる微細化に対応したフライングプローブテスタFA1823の受注を開始しました。同製品の発売は2025年10月ごろを予定しています。FA1823は直径わずかΦ19µmの極微細パッドへの高精度プロービングを実現し、このサイズのパッドでの4端子低抵抗測定(ケルビン測定)※2を業界で唯一※3実現しています。開発、品質管理、製造現場が抱える課題を解決し、ICパッケージ基板の生産ラインにおける検査歩留まりと長期品質を大幅に向上します。
開発の背景
AI技術は世界的に急速な広がりを見せており、半導体市場ではHPC(High Performance Computing、ハイパフォーマンスコンピューティング)をはじめ、EV (Electric Vehicle,電気自動車)、5Gなどの需要により演算性能の飛躍的向上と低消費電力化が急務となっています。ICパッケージはこれらの課題を解決するためにチップレット技術や2.5D/3D実装※4を採用した微細化、高密度化が進められています。特にFCBGA※5およびシリコンブリッジ※6、ガラス基板※7などを活用した高密度ICパッケージ基板では、パッド径や配線ピッチの微細化が急速に進行しており、製造工程における電気検査には従来以上の接触精度と測定分解能が求められるようになってきました。
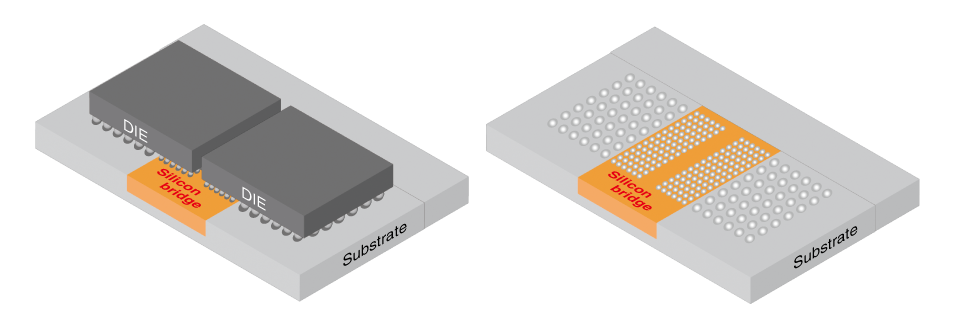 シリコンブリッジ基板の例
シリコンブリッジ基板の例
最先端の高密度ICパッケージ基板では微細化が進んでおり、既存の検査装置では限界がありました。そこでFA1823ではメカトロニクスと測定アルゴリズムを全面的に刷新し、未知の領域を測る“Probe the Unprobeable.”というコンセプトのもと従来のフライングプローブテスタの限界を超えることに成功しました。FA1823はICパッケージ基板の断線/短絡の検査にとどまらず、配線抵抗測定によるロット品質評価などによりユーザーの工程改善支援にも活用可能です。当社は高密度ICパッケージの検査を通して、様々な社会課題を解決する最先端技術の社会実装を支援いたします。
製品の特長
1.Φ19µmパッドへの高精度プロービング
高剛性フレームとオートプローブキャリブレーション、超微細ケルビンプローブを新規開発し、従来比約67%の高精度化を達成しました。プローブ位置決め分解能0.1µmを実現し、極小パッドでも確実にプロービング。さらに将来的には、プローブの進化によりΦ15µmパッドまでの対応を目指します。
2.業界唯一の微細パッド対応4端子低抵抗測定
接触抵抗の影響を受けない4端子低抵抗測定(ケルビン測定)を微細なパッドでも実現。mΩレベルの低抵抗を高速測定し、信頼できる実測値によるロット品質評価を実現します。
3.プローブ交換時のメンテナンス作業性向上
プローブ交換後の調整作業を完全自動化。ダウンタイムの短縮、作業性向上によりオペレータ負荷軽減、ヒューマンエラーを排除し確実なプロービングを実現します。
主な用途
- FCBGA方式のICパッケージ基板における導通・絶縁・配線抵抗検査
- シリコンブリッジ搭載ハイブリッドパッケージの電気検査
- 2.5D/3D ICチップレット向けRDL※8の試作品、開発品の品質検査
- AIアクセラレータ※9、HPC、GPU※10、EVにおけるADAS※11、パワーモジュール用高密度BGAパッケージ基板の検査
受注開始日
2025年5月1日
製品発売日
2025年10月20日
- ※1ICパッケージ基板:ダイ(半導体チップ)をプリント基板(PCB)に実装する前に取り付け、電気信号や電源を配線する多層構造の中間基板。インターポーザ、ICサブストレートなどの種類がある。
- ※24端子低抵抗測定(ケルビン測定):電流端子と電圧端子を分離し、接触抵抗やリード抵抗の影響を排除して抵抗値を高精度に測定する方法。
- ※3当社調べ(2025年5月時点)。Φ19µmの微細パッドにプロービングできる4端子低抵抗測定を標準搭載するフライングプローブテスタとして。
- ※42.5D/3D ICチップレット:複数ダイを立体的に近接接続することで高密度化し、高速で低消費電力なICパッケージを実現する技術。
- ※5FCBGA(Flip Chip Ball Grid Array):チップをフリップチップ実装し、基板裏面のはんだボールで接続する高密度パッケージ形態。放熱に強い特徴がある。
- ※6シリコンブリッジ:複数チップを狭ピッチで接続するための超微細端子を備えたシリコンインターポーザ。基板面積を抑えつつ高速信号伝送を実現する。
- ※7ガラス基板:従来の有機基板に代わる材料として、特に高密度実装・高周波対応・高熱伝導性などが求められる最先端半導体パッケージ分野での活用が進んでいる。
- ※8RDL(Redistribution Layer):ICパッケージ基板においてチップの配線を再配線し、高密度化、多層接続、小型化を実現する配線層。
- ※9AIアクセラレータ:AI計算に特化した専用プロセッサで、行列演算を高速・低電力で実行し学習・推論を加速する半導体チップ。
- ※10GPU(Graphics Processing Unit):画像処理向け並列計算プロセッサ。従来は3DCG描画や数値計算などの多数並列演算に用いられてきたが、近年は高速なAI推論や学習に有用なことから需要が増加している。
- ※11ADAS(Advanced Driver Assistance System):運転支援システム。カメラやレーダーにより安全運転を補助するための技術。
記載されている情報は本文章発行日現在のものです。予告なしに本文章に記載の情報は変更になる場合があります。本文章で使用している会社名および製品名は、各社の登録商標もしくは商標です。
